우리는 지난 반세기 동안 우리는 Moore의 법칙을 생각하게 되었습니다. 즉, 주어진 실리콘 면적에서 트랜지스터의 수가 대략 매 두 해마다 두 배로 증가하여 컴퓨팅을 발전시키는 이득을 얻는 것을 자연적이고 불가피한 과정인 것처럼 그냥 발생하는 것으로 여기게 되었습니다. 그러나 현실은 달라요. Moore의 법칙과 발맞추기 위해서는 거의 상상할 수 없는 시간, 에너지 및 인간적 창의력의 비용이 필요합니다. 지구상에서 가장 복잡한 기계장비들로 무한한 면적을 가득 채우며 전 세계 여러 대륙에서 수천 명의 사람들이 참여해야 합니다.
이러한 기계 중 가장 중요한 것 중 하나는 극자외선(EUV) 리소그래피(photolithography)를 수행하는 기계입니다. 수십 년간의 연구 개발 끝에 나온 EUV 리소그래피는 지난 3년 동안 모든 최고급 스마트폰, 태블릿, 노트북 및 서버에 사용된 최첨단 칩의 뒷받침 기술로 자리 잡았습니다. 그러나 Moore의 법칙은 지속되어야 하며, 칩 제조업체들은 계속해서 기술 발전 로드맵을 진행하여 장치 기하학을 더욱 축소해야 합니다.
그래서 ASML사에서는 높은 수치 조리개(HighNA)를 갖춘 EUV 리소그래피라고 불리는 이 기술은 시스템의 내부 광학을 크게 개편하는 것을 포함합니다. High NA EUV는 2025년에 상용화될 예정이며, 칩 제조업체들은 이 기술의 성능에 기대어 이번 10년 마지막까지 약속한 발전을 이뤄낼 것으로 기대하고 있습니다.
리소그래피의 3요소는 다음과 같습니다. 무어의 법칙은 리소그래피(photolithography)의 해상도 향상을 기반으로 하여 칩 제조업체가 점점 더 미세한 회로를 배치할 수 있도록 합니다. 지난 35년 동안, 엔지니어들은 빛의 파장, 프로세스와 관련된 요소를 포함하는 계수인 k1, 그리고 광학 시스템이 빛을 방출하는 각도 범위를 측정하는 수치 조리개 (NA)의 조합에 작업을 기울여, 해상도를 2차원 정도 개선해왔습니다. "임계치(dimension) 반도체에서는 CD라고 미세선폭이라고 함"라고도 하는데, 이는 특정 리소그래피 노광기로 인쇄할 수 있는 가장 작은 가능한 특징 크기를 의미하며, 빛의 파장을 광학 시스템의 수치 조리개로 나눈 값에 비례합니다. 따라서 더 짧은 빛 파장이나 더 큰 수치 조리개 또는 두 요소의 조합을 사용하여 더 작은 임계치를 달성할 수 있습니다. 예를 들어, 더 짧은 빛 파장을 사용하거나 수치 조리개를 향상시키고 제조 공정을 통제하여 k1 값을 물리적 하한인 0.25에 가능한 한 가깝게 미세 조정할 수 있습니다.

일반적으로 해상도를 향상시키는 가장 경제적인 방법은 수치 조리개를 높이고 k1을 줄이기 위해 도구와 공정 제어를 개선하는 것입니다. 수치 조리개와 k1을 더 이상 개선할 옵션이 없을 때에만 빛 원본의 파장을 줄이는 방법을 사용합니다.
그러나 산업은 이러한 파장 변화를 여러 차례 수행해야 했습니다. 역사적으로 파장은 수은 램프를 사용하여 생성된 365 나노미터에서 1990년대 후반에 KrF 레이저를 통해 248 나노미터로, 그리고 이 세기 초에 ArF 레이저를 통해 193 나노미터로 진화했습니다. 각 세대의 파장에 대해, 리소그래피 시스템의 수치 조리개가 점진적으로 증가되었으며, 이후에 더 짧은 파장으로 전환되었습니다.
예를 들어, 193 나노미터의 사용이 끝남에 따라, 수치 조리개를 증가시키기 위한 새로운 방법으로 "immersion lithography"가 소개되었습니다. 렌즈 하단과 웨이퍼 사이에 물(Water)를 두어 수치 조리개를 0.93에서 1.35로 크게 확장할 수 있었습니다. 2006년쯤 처음 소개된 193 나노미터 수지 리소그래피는 최첨단 리소그래피 분야에서 사용되었습니다.

EUV의 도래
하지만 30 나노미터보다 작은 기능을 출력해야 하는 필요성이 증가하고, 193 나노미터 리소그래피의 수치 조리개 (NA)가 최대치에 도달함에 따라, Moore의 법칙을 따라가는 것은 더욱 복잡해졌습니다. 30 나노미터보다 작은 기능을 생성하려면 하나의 칩 기능 층을 생성하기 위해 여러 패턴을 사용해야 하는 기술적, 경제적 부담이 따르거나, 다른 파장으로의 전환이 필요합니다. 20년 이상의 시간과 전례없는 개발 노력이 걸렸지만, 다음 새로운 파장인 13.5 나노미터 EUV가 들어왔습니다.
EUV는 완전히 새로운 방식으로 빛을 생성하는 것이 필요합니다. 이는 강력한 CO2 레이저로 용융물방울을 가운데서 맞추는 놀라운 복잡한 과정입니다. 레이저는 플라즈마로 기화시켜 광자 에너지 스펙트럼을 방출합니다. 이 스펙트럼에서 EUV 광학은 필요한 13.5 나노미터 파장을 수확하고 그것을 웨이퍼에 패턴화된 마스크에 반사시켜 웨이퍼 위에 해당 패턴을 투사합니다. 이 모든 작업은 초고진공 상태에서 이루어져야 합니다. 왜냐하면 13.5 나노미터 파장은 공기에 흡수되기 때문입니다. (이전 세대의 리소그래피에서는 빛이 마스크를 통과하여 웨이퍼에 패턴을 투사했습니다. 그러나 EUV는 빛이 쉽게 흡수되기 때문에 마스크와 다른 광학 시스템은 반사형이어야 합니다.)
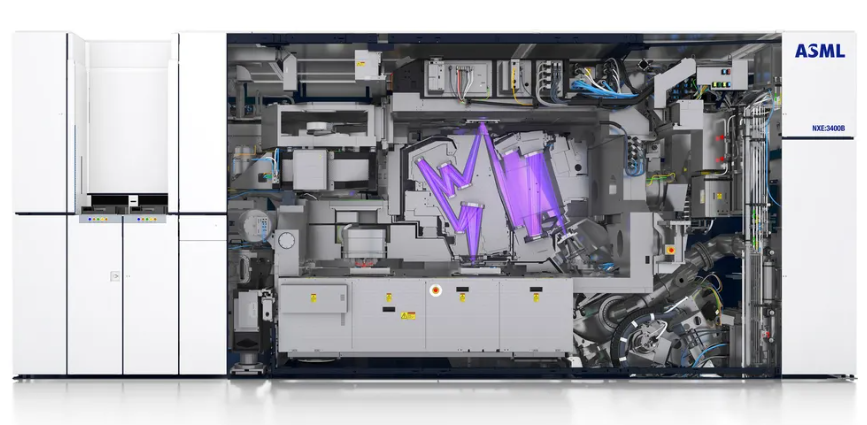
193 나노미터 빛에서 EUV로의 전환은 CD를 감소시키는 일부 작업을 수행했습니다. "제조용 설계(design for manufacturing)"라는 과정은 리소그래피의 한계를 활용하기 위해 회로 블록의 설계 규칙을 설정하는 것으로, k1을 줄이는 데 많은 역할을 했습니다. 이제 수치 조리개를 다시 오늘날의 0.33에서 0.55로 증가시킬 때입니다.
높은 NA EUV의 구현
오늘날의 0.33에서 목표치인 0.55로 NA를 증가시키는 것은 필연적으로 다른 많은 조정을 수반합니다. EUV 리소그래피와 같은 투사 시스템은 웨이퍼와 마스크에서 모두 NA를 가지고 있습니다. 웨이퍼의 NA를 증가시키면 마스크의 NA도 증가합니다. 따라서 마스크에서 들어오고 나가는 빛의 원뿔이 커지고 서로 겹치지 않도록 각도를 조정해야 합니다. 빛의 원뿔이 겹치면 비대칭적인 회절 패턴이 발생하여 불쾌한 이미징 효과가 발생합니다.

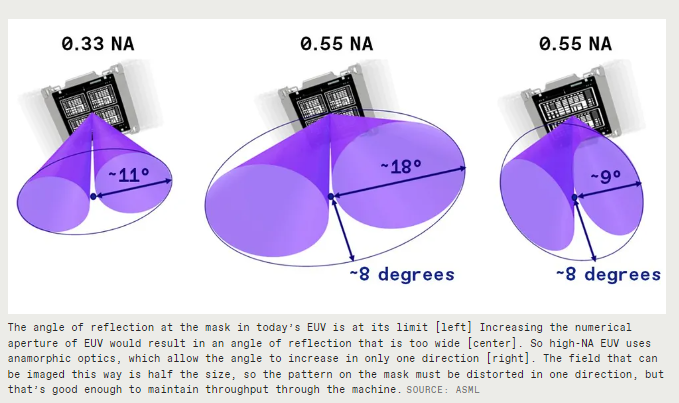
하지만 이 각도에는 한계가 있습니다. EUV 리소그래피에 필요한 반사형 마스크는 사실 여러 재료의 다층으로 만들어지기 때문에 특정 반사각 이상에서 적절한 반사를 보장할 수 없습니다. EUV 마스크의 최대 반사각은 11도입니다. 다른 어려움도 있지만, 반사각이 가장 큰 문제입니다. 이 도전을 극복하는 유일한 방법은 축소 품질을 증가시키는 것입니다. 축소 품질은 그 이름 그대로 마스크로부터 반사된 패턴을 축소하는 것을 의미합니다. 반사각 문제를 보상하기 위해, 저와 제 동료들은 축소 품질을 8배로 늘려야 했습니다. 이로 인해 마스크가 웨이퍼 상에서 투사되는 부분이 훨씬 작아집니다. 이 작은 이미지 필드로 인해 완성된 칩 패턴을 생성하는 데 더 많은 시간이 걸릴 것입니다. 실제로 이 요구사항은 높은 NA 스캐너의 생산성을 1시간에 100개 미만의 웨이퍼로 감소시킬 것입니다. 이러한 생산성 수준은 칩 제조를 경제적으로 어렵게 할 것입니다.
다행히도, 우리는 가장 큰 반사각이 발생하는 방향에서만 축소 품질을 증가시키면 되는 것을 발견했습니다. 다른 방향의 축소 품질은 변경하지 않아도 됩니다. 이로 인해 웨이퍼 상의 수용 가능한 필드 크기가 형성되며, 현재의 EUV 시스템보다 약 절반 크기인 26 x 16.5 밀리미터로 26 x 33 밀리미터 대신 사용됩니다. 이러한 방향 종속적인, 즉 비등방성(anamorphic) 축소는 높은 NA 시스템의 기초를 이룹니다. 광학 제조업체인 Carl Zeiss는 우리의 새로운 기계에 필요한 사양으로 비등방성 렌즈를 설계하고 제조하는데 헤라클레스 같은 노력을 기울였습니다.
절반 크기의 필드로도 동일한 생산성 수준을 보장하기 위해, 마스크와 웨이퍼를 보유하는 플랫폼인 시스템의 레티클과 웨이퍼 스테이지를 다시 개발하고 스캔 과정이 진행되는 동안 서로 동기화하여 이동시켜야 했습니다. 이 재설계로 나노미터 정밀도의 스테이지가 만들어지며 가속도가 4배 향상되었습니다.
2025년에 생산될 높은 NA EUV
첫 번째 높은 NA EUV 시스템인 ASML EXE:5000은 2024년 초에 벨기에의 나노전자 연구 시설인 Imec과 공동으로 개설하는 새 실험실에 설치될 예정입니다. 이 실험실에서는 고객, 마스크 제조업체, 광각각 공급업체 등이 높은 NA EUV를 실현하기 위해 필요한 인프라를 개발할 수 있습니다.
이것을 실현하는 것이 매우 중요한데, 높은 NA EUV는 Moore의 법칙을 유지하는 데 중요한 요소입니다. 하지만 0.55 NA에 도달하는 것이 마지막 단계는 아닙니다. ASML, Zeiss 그리고 전체 반도체 생태계는 여기에서 더 나은, 더 빠른, 상상할 수 없는 혁신적인 기술을 향해 더욱 노력할 것입니다.
* 참고: 본문은 해외기사에서 발췌한 내용을 이해하기 쉽게 해석한 내용입니다.
'반도체' 카테고리의 다른 글
| 순간의 정책결정의 실수로 국민혈세 3000억을 날린 비운의 반도체공장 (2) | 2023.08.27 |
|---|---|
| 회계흐름으로 보는 반도체장비투자 SC(부품생태공급망)의 생태계와 실적영향. 라온테크,테스 2023년2분기 기준 (3) | 2023.08.13 |
| 대한민국 반도체의 역사의 시작과 삼성전자 반도체 기흥사업장 (0) | 2023.08.04 |
| 태양광모듈의 정션박스(JunctionBox)안의 다이오드(Diode)의 기능 (0) | 2023.06.17 |
| 최신 반도체칩의 수율경쟁안에 숨어있는 EUV Pellicle(극자외선 페리클)의 역할.인텔,TSMC,삼성.애플의 기술경쟁의 이해 (2) | 2022.07.30 |